
信息来源:原创 时间:2023-08-16浏览次数:4175 作者:鸿达辉科技
金彩汇今年,伴随着人工智能产业的迅速发展,智能产品的不断出现,智能制造已成为一种常态;目前全球的芯片工业,已经发展到了一个非常庞大的地步。芯片的制造包括芯片设计、芯片制造、封装制造和测试等过程,其中采用鸿达辉科技可视点胶设备对芯片的封装过程是非常重要的。根据资料显示,在芯片封装过程中, BGA不良率大约为6%,无法再次返修的板卡比例达到了90%,而掉点的位置大多集中在四个角落,其原因根据分析,主要是由于散热片应力、现场环境有震动、板卡变形应力等造成的。
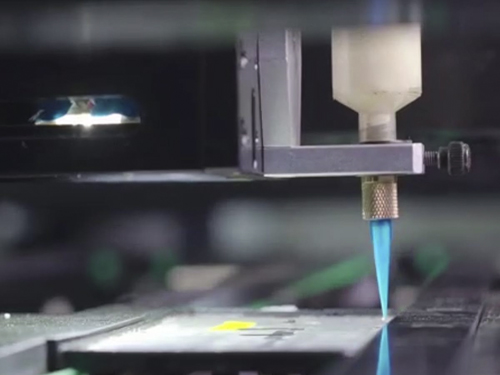
金彩汇一、高标准“中国芯”
金彩汇在国内,虽然智能芯片的应用越来越多,但良品率并没有相应的提高。在芯片制造过程中,高品质的底填封装技术,也是制约高规格“中国芯”的一个关键因素,下面是鸿达辉科技为您带来的晶圆级芯片产品的底部填充工艺要求:
金彩汇1、操作与效率需求:对于基片的灌装速度,胶水的凝固时间与凝固模式,以及可回收性,都有较高的要求。
2、产品的功能需求:充填效果好,不会产生气泡,减少气孔,增强芯片的抗冲击能力。
3、可靠性要求:芯片品质的密封性、粘附性、表面的绝缘电阻、恒温恒湿、冷热冲击等均达到标准。
鸿达辉科技是一家专业研究、开发、制造各种精密点胶设备的专业公司,公司生产的喷射型视觉点胶机,使用了德国高精度喷射器,可达到精细、精确的点胶效果,已广泛用于各种精益点胶场合,是当前我国精益点胶的主流设备。
Consult Manufacturer